3D封装的关键工艺详述
2025-02-04 09:16:10 101
3D封装
3D封装作为半导体封装技术的一个重要发展方向,其关键工艺和技术特点在摩尔定律的推动下日益受到关注。3D封装继续遵循摩尔定律,追求更高的集成度和性能的同时,又转向更加务实的满足市场需求,不再一味追求功耗下降和性能提升。
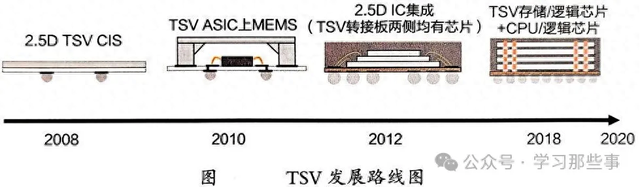
TSV(Through Silicon Via)技术是半导体集成电路产业迈向3D SiP时代的关键技术,本文对其进行介绍,分述如下:
CIS的TSV封装工艺详解
3D TSV封装工艺流程
TSV电镀铜工艺
1
CIS的TSV封装工艺详解
CIS(CMOS Image Sensor)的TSV(Through Silicon Via)封装工艺是半导体封装领域中的一项重要技术,它通过将硅穿孔实现上下线路的连通,虽然尚未达到3D集成的高度,但仍是当前封测工艺的关键组成部分。以下是对CIS的TSV封装工艺的详细阐述:
一、TSV技术的分类与CIS的应用
TSV技术根据深径比和电镀铜的填充方式可分为两大类:
等壁生长的TSV镀铜:适用于深径比较小的应用,如影像传感器、指纹识别芯片的封装。
超级填充电镀铜的TSV:主要用于MEMS等领域。
CIS的TSV封装工艺属于等壁生长的TSV镀铜类型,它利用硅穿孔实现芯片内部电路的互连,与SiP系统中的TSV集成概念有所区别,但仍是封装工艺中的重要一环。
二、CIS的TSV封装工艺流程
CIS的TSV封装工艺流程中,化学镍金制程是凸块下金属化(UBM)的重要结构。
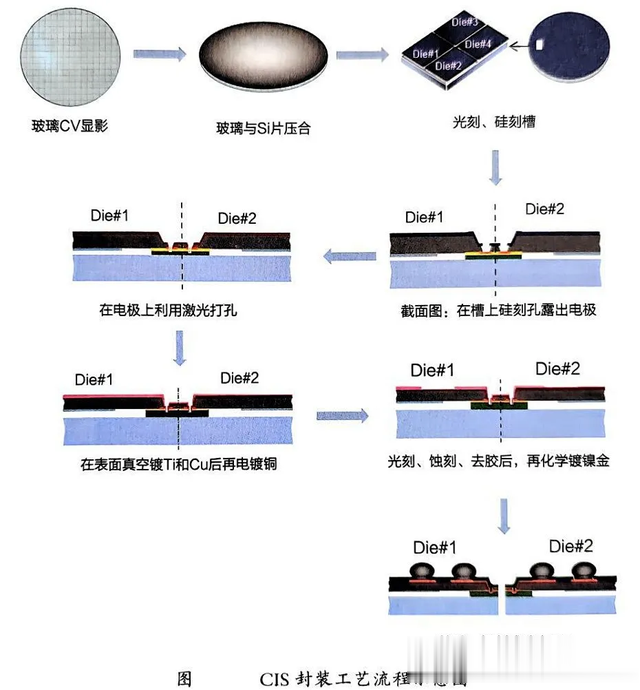
化学镍金或镍钯金工艺不仅适用于CIS封装,还可作为打线、焊料或锡球置底的UBM结构。

其中,镍层作为阻挡层防止基材与焊料或金线的扩散;钯层具有进一步降低扩散和提高打线键合作用;金层则具有良好的抗氧化能力和打线功能。
三、化学镀金的优势与环保趋势
长期以来,化学镀金采用氰化亚金钾作为主盐,但随着环保要求的提高,无氰化学金方式逐渐取代氰化物镀金。化学镀相比电镀具有设备要求低、金槽开缸浓度低、镀层均一性好、节省金盐降低成本等优势。此外,化学镀生产效率高,且镀区不受图形线路限制,具有投资低的优势。近年来,有人尝试利用化学镀铜代替真空镀铜,进一步探索降低成本和提高效率的可能性。
四、国内CIS封装工艺的发展
目前,国内以华天科技为代表的多家企业已具备CIS封装工艺的量产能力。随着影像传感器市场的不断扩大和技术的不断进步,CIS的TSV封装工艺将在封装行业中发挥越来越重要的作用。
综上所述,CIS的TSV封装工艺作为半导体封装领域的重要技术之一,具有广泛的应用前景和市场潜力。随着技术的不断进步和环保要求的提高,该工艺将在封装行业中发挥更加重要的作用。
2
3D TSV封装工艺流程
3D TSV(Through Silicon Via)封装工艺是一种高密度封装技术,它通过硅通孔技术实现多层芯片的垂直堆叠和互连。以下是3D TSV封装工艺的主要流程和关键点的详细介绍:
一、主要工艺流程
孔成型
方式:激光打孔、干法刻蚀(如深反应离子刻蚀DRIE)、湿法刻蚀等。
关键:对于较大深径比的硅基TSV孔型,主要采用氟基气体的干法刻蚀方式,确保孔的光洁度、垂直侧壁和正确深度。
二、沉积介电层、种子层
介电层:采用化学气相沉积(CVD)方式,在硅片表面形成固态薄膜或涂层,作为绝缘层。
种子层:采用物理气相沉积(PVD)方式,先溅射一层钛(提高结合力、阻挡铜与硅的扩散),再溅射一层铜(为后期电镀铜提供导电性)。
电镀铜
作用:实现TSV的电气互联。
优点:导电性、导热性好,异质集成功能强。
现状:尽管有尝试用导电浆料、导电银粉等代替电镀铜的研究,但尚未实现量产,目前主流厂商仍采用电镀铜方式。
CMP(化学机械抛光)
作用:去除表面铜层,减薄硅片背面,使通孔电镀铜外露,为后期多层叠加的铜互连做准备。
过程:通过化学反应和机械抛光相结合,去除硅片表面层,终点监测功能判断抛光程度,最后清洗去除颗粒污染物。
注意:电镀后CMP前会有回火工艺,以降低电镀铜的内应力。
叠加互连
堆叠形式:晶圆到晶圆(W2W)、芯片到晶圆(C2W)或芯片到芯片(C2C)等。
键合方式:直接Cu-Cu键合、黏接、直接熔合、焊接和混合等方式。
二、关键点分析
深孔填充技术:TSV深孔填充技术是3D集成的关键技术之一,填充效果直接关系到集成技术的可靠性和良率。采用电镀铜等先进填充技术,确保高深宽比通孔的完全填充,无空洞、夹缝等缺陷。
CMP工艺控制:CMP工艺是TSV封装中的重要环节,需要精确控制抛光厚度和均匀性。采用先进的CMP设备和终点监测技术,确保抛光质量。
材料选择与匹配:介电层、种子层和填充材料的选择对TSV的性能有重要影响。需要根据具体应用需求选择合适的材料,并确保材料之间的良好匹配和兼容性。
工艺优化与整合:TSV封装工艺涉及多个环节和多种技术,需要进行工艺优化和整合。通过改进工艺流程、提高设备精度和自动化水平等方式,降低生产成本,提高生产效率和产品良率。
3
TSV电镀铜工艺
TSV电镀铜工艺是TSV技术中的关键制程之一,其包括种子层沉积、电镀前处理、电镀铜超级填充、电镀后处理等多个步骤。
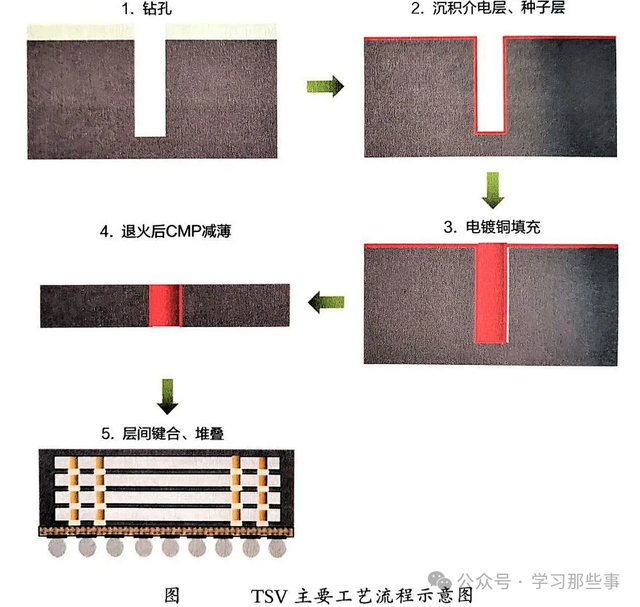
通过精确控制电镀参数和添加剂的配比,可以实现高深径比的填充,并保证填充过程中不产生空洞、夹缝等缺陷。
一、种子层沉积
在电镀铜之前,需要在TSV孔的内壁和表面沉积一层导电的种子层。种子层是电镀的基本保障,有提供导电性使电镀顺利进行的功能。

一般会选用钛和铜作为种子层材料,对于超高深径比或特殊结构,可能需要采用金种子层以增强导电性。种子层的质量对电镀效果有重要影响,一般通过切片观察孔内金属层的颜色来判断其质量,正常的红色表示种子层达到要求,孔壁发黑则可能容易导致空洞、断层、夹缝等风险。一般钛种子层厚度为0.1~0.5微米,铜种子层为1.0~2.0微米。
二、电镀前处理
在完成种子层沉积后,进入电镀工序。电镀工序主要包括前处理和电镀铜的超级填充两步。前处理是利用物理方式排出腔体内的空气,如用超声波、喷淋、抽真空等方式,使电镀液顺利进入腔体内部。
三、电镀铜超级填充
前处理完毕后,开始进行电镀铜的超级填充。
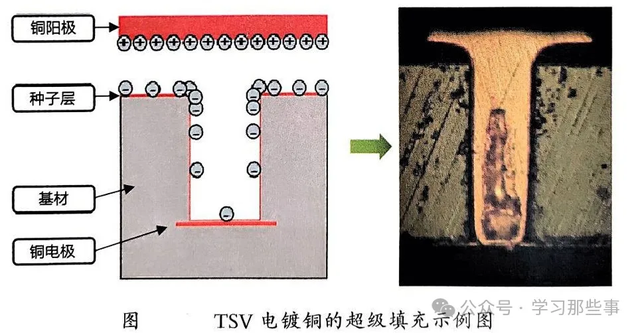
电镀铜是TSV实现电气互连的主要方式,其具有良好的导电性、导热性,以及非常好的异质集成功能。TSV电镀铜一般采用硫酸铜体系,也有部分厂商采用甲基磺酸铜体系,但以硫酸铜体系为主。电镀液中的铜离子在阴极上接收电子并沉积在过孔内壁的功能金属层上。电镀过程中,需要控制电镀液的温度、搅拌速度以及电流密度等参数,以保证铜离子的均匀沉积。电镀温度一般在23℃~28℃,温度太低容易造成铜离子扩散慢,温度太高则添加剂消耗快。
在电镀铜的超级填充过程中,电镀添加剂起着至关重要的作用。
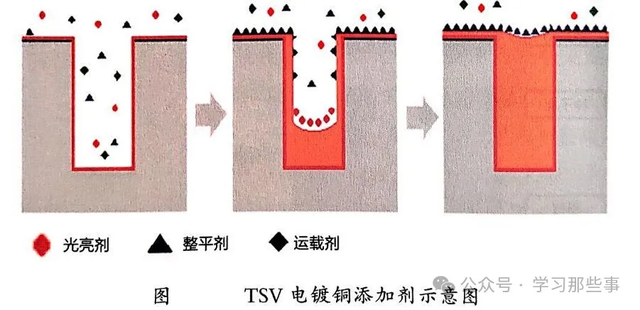
添加剂一般分为三种:光亮剂(加速剂)、运载剂(辅助剂或润湿剂)和整平剂。光亮剂有利于较大电流密度区的铜离子有序沉积;运载剂具有降低溶液表面张力的能力,且有利于孔底润湿;整平剂容易在TSV表面或孔口吸附,阻止铜离子的沉积,使铜离子在整平剂较少的孔底生长。通过三种添加剂的配合,以合适的电流密度,可以实现高深径比的填充,且填充过程中不允许产生空洞、夹缝现象。
四、电镀后处理
电镀完成后,需要进行高温退火处理,以释放镀层存在的内应力。退火温度一般为300℃,时间为0.5小时。退火完成后,再进行CMP(化学机械抛光)减薄处理,以去除表面的铜层,并将硅片背面减薄,使通孔电镀铜外露,为后期的多层叠加的铜互连做好准备。CMP工艺的过程包括硅片和抛光盘之间通过磨料与表面材料发生化学反应生成一层相对容易去除的表面层,然后通过对抛光盘上施加向下的压力与抛光垫的相对运动磨去表面层。
来源于学习那些事,作者小陈婆婆

新闻动态
热点资讯
-
1.舞剧《她的龟兹》, 承载着什么?
- 1

- 舞剧《她的龟兹》, 承载着什么?
- 2026-04-29
- 1
-
2.200mm轴距革命! 仰望U8L把"陆地头
- 2

- 200mm轴距革命! 仰望U8L把"陆地头
- 2025-07-19
- 2
-
3.猫眼研究院年度数据洞察: 市场规模修复 动画电影票房贡献显著
- 3

- 猫眼研究院年度数据洞察: 市场规模修复 动画电影票房贡献显著
- 2026-02-06
- 3
-
4.多部委联合发文提升创业质量,完善创业支持体系
- 4

- 多部委联合发文提升创业质量,完善创业支持体系
- 2025-03-06
- 4
-
5.中国“国网”卫星群: 开启太空通信新时代
- 5

- 中国“国网”卫星群: 开启太空通信新时代
- 2025-09-07
- 5
-
6.3D封装的关键工艺详述
- 6

- 3D封装的关键工艺详述
- 2025-02-04
- 6
-
7.克宫:还在等美方解释
- 7

- 克宫:还在等美方解释
- 2025-11-23
- 7
-
8.新西兰对华免签刚松绑,当地华人包车商早已卷到血流成河
- 8

- 新西兰对华免签刚松绑,当地华人包车商早已卷到血流成河
- 2025-06-25
- 8
-
9.青岛啤酒入选《国资国企社会责任蓝皮书(2025)》 高质量履
- 9

- 青岛啤酒入选《国资国企社会责任蓝皮书(2025)》 高质量履
- 2025-12-15
- 9
-
10.经济回暖信号释放 服务消费热度指数上涨20.1%
- 10

- 经济回暖信号释放 服务消费热度指数上涨20.1%
- 2025-04-15
- 10
